hppms大功率脉冲磁控溅射pvd涂层技术
高功率脉冲磁控溅射(HPPMS),也称为高功率脉冲磁控溅射(HIPIMS)是基于磁控溅射沉积的 PVD 涂层技术。HPPMS 利用 kW / cm 2量级的极高功率密度在小于10%的低占空比(开/关时间比)下,以数十微秒的短脉冲(脉冲)为单位。HPPMS的显着特征是溅射金属的高度电离和分子气体的高解离速率,这导致了沉积膜的高密度。电离和解离度根据峰值阴极功率而增加。该极限由放电从辉光到电弧相的过渡确定。选择峰值功率和占空比,以保持类似于常规溅射的平均阴极功率(1-10 W / cm)。
HPPMS 用于:
- 在涂层沉积之前对基底进行粘合力增强的预处理(基底蚀刻)
- 沉积具有高微结构密度的涂层
HPPMS工艺可将较大的低能量离子通量传递给基板。电源必须产生最高3 MW/脉冲的峰值功率,脉冲宽度在100到150μs之间。/脉冲的峰值功率,脉冲宽度在 100 到 150μS 之间。平均功率约为 20 kW,频率高达 500 Hz。除了提供脉冲功率外,还必须进行电弧抑制。该过程利用了高能量脉冲产生的增强电离的优势。施加至靶材的功率密度约为 1 - 3 kW / cm。 2(与功率密度约为 1 - 10 W / cm 2的传统磁控溅射相比)[2]。
由于增强的电离作用,可以使用 HPPMS 来完成晶体膜的生长以及控制其相组成[3]。沉积条件同样很重要,但是电源的占空比和等离子体参数似乎有助于形成晶体结构。 2的金红石相随脉冲周期而增加,随密度随脉冲幅度而降低[3]。然而,其他研究人员没有看到这种现象,仅获得了非晶膜,而沉积了高结晶度的钛[4]。
结果,HPPMS涂层应具有改善的摩擦学,光学,电学和环境性能。改善的微结构也改善了光学性能[3,4,5-9]。众所周知,折射率取决于光学涂层的密度。密度较小的涂层的折射率通常低于密度较高的涂层。 2涂层是依赖于密度的完美例子。这种材料的折射率可以在2.2 - 2.5之间变化,具体取决于密度。据报道,与直流磁控溅射膜相比,由HPPMS沉积的膜具有较高的折射率,如图1所示[5]。在整个光谱上折射率较高。这些涂层的密度也为3.83 g / cm。 3DC 膜的密度为 3.71 克/厘米 3如果使用电源的最佳占空比,则 TiO 2的折射率也很高,约为2.72 [3]。 2氧化锌,铝 2 O 3Ta,Ta 2 O 5和氧化锆 2的光学常数总是在很大程度上取决于沉积条件,并且必须为每种材料和沉积系统确定最佳的一组条件。

hppms工艺的另一个优点应该是改善化学和环境稳定性。银涂层因缺乏化学和环境稳定性而臭名昭著,特别是非常薄的涂层。 尽管仍有许多测试要做,但hppms沉积的银膜似乎在多层结构中具有更高的稳定性和光学性能[9]。
随着密度和光滑度的提高,该工艺具有改善摩擦涂层性能的潜力[11-15]。具有致密的微观结构和光滑表面的涂层在许多应用中是优选的,因为它增加了耐腐蚀和耐磨性,并减少了摩擦。 xCr x N y和 Ti 3 SiC 2的硬质材料均已通过HPPMS沉积。与直流磁控溅射沉积相比,TiN涂层具有非常细的晶粒结构[19]。CrN涂层甚至比UBM溅射涂层具有更好的微观结构。据报道硬度值接近25 GPa,滑动磨损系数从7降低到0.2 [15]。
HPePMS还沉积了VMeCN和CrN / NbN摩擦超晶格涂层[16,17]。这些结构显示出新的高硬度值和低COF。TiAlCN / VCN超晶格显示出较高的硬度值(Hv = 2900 kg / mm)。 2该过程中的一个重要步骤是用HPPMS沉积的V和Nb预处理基材。
几种资源指出HPPMS膜应具有较低的机械应力[17]。虽然应力的测量结果不充分,但据报道CrN涂层的应力在3GPa附近[15] 23。在碳膜中测得的应力范围为1.6 GPa至6.5 GPa [18]。在TiN涂层中也测得了低应力[19,20]。
HPPMS已被用于沉积低电阻率的ITO膜[21],并显示出有望总体上改善TCO的性能。ZOn:Al膜也已通过此过程沉积。几乎所有相关报告都将HPPMS涂层与DC磁控溅射涂层进行了比较。图2比较了HPPMS和在300 C下沉积的DC溅射膜的表面形态[22]。再次注意HPPMS膜的表面非常光滑。图3比较了两种方法(9a - DC和9b - HPPMS)沉积的电阻率膜。在一个O由DC方法来实现的电阻率。2为1SCCM的流量为〜3.2×10 -3 Ω.cm(在本领域 ITO 的绝对状态),而 HPPMS 方法的电阻率是 3.1〜×10 -3 Ω.cm为相同的O 2作者认为这是一个很大的差异,电阻率最低报道的值是 1.35×10 -3 Ω.cm直流膜和〜1.25 X10 -3 Ω.cm为HPPMS膜。HPPMS的真正优势似乎在于涂层的光滑度,而HPPMS赢得了人们的青睐。
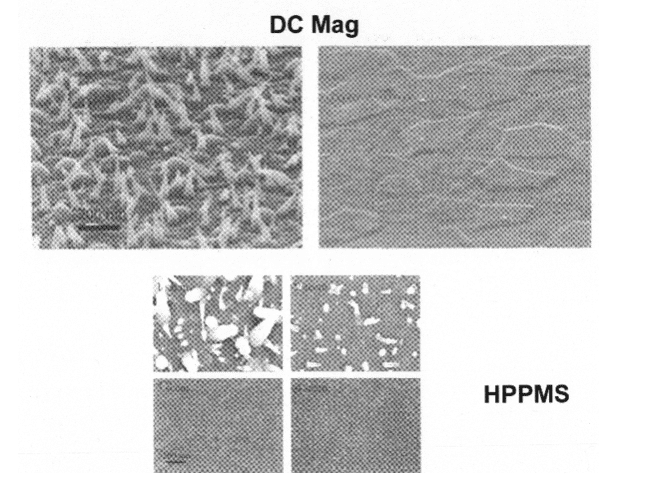

转至http://vtcmagblog.com/
参考:
- D J Christie 等人,第 47 届真空镀膜机协会年度技术会议(2004 年)113。
- William D. Sproul,《真空镀膜技术 50 年与真空镀膜机协会的发展》,Donald M. Mattox 和 Vivienne Harwood Mattox 编辑,真空镀膜机协会(2007 年)35。
- R Bandorf 等人,真空镀膜机协会第 50 届年度技术会议(2007 年)160。
- J A Davis 等人,第 47 届真空镀膜机协会年度技术会议(2004 年)215。
- K Sarakinos 等人,Rev. Adv.Sci, 15 (2007) 44.
- S Konstantinidis 等人,真空镀膜机协会第 50 届年度技术会议(2007 年)92。
- W.D. Sproul、D.J. Christie 和 D.C. Carter,第 47 届真空镀膜机协会年度技术会议(2004 年)96。
- D A Glocker 等人,第 48 届真空镀膜机协会技术会议记录(2005 年)53。
- J Li、S R Kirkpatrick 和 S L Rohde,SE-TuA1 演讲,AVS 2007 秋季技术会议,2007 年 10 月 14 - 19 日,华盛顿州西雅图。
- D A Glocker 等人,第 47 届真空镀膜机协会年度技术会议(2004 年) 183
- A P Ehiasarian 等人,第 45 届真空镀膜机协会技术会议记录(2002 年)328。
- J Böhlmark 等人,第 49 届真空镀膜机协会技术会议记录(2006 年)334。
- J Alami 等人,《薄固体薄膜》515 (4):1731-1736.
- A P Ehiasarian 等人,《表面与涂层技术》163-164:267-272。
- J Paulitsch 等人,《真空镀膜机协会第 50 届技术会议记录》(2007 年),第 150 页。
- A P Ehiasarian 等人,第 49 届真空镀膜机协会技术会议记录(2006 年)349。
- W D Sproul,《真空镀膜机协会第 50 届技术会议记录》(2007 年)591 页
- B M DeKoven 等人.第 46 届真空镀膜机协会技术会议记录(2003 年)158
- SE+PS-MoA1:R. Chistyakov,"Modulated Pulse Power Deposition ofNanometer-Scale Multilayered Coatings",2008 年 10 月 21 日在华盛顿州西雅图举行的 2008 年美国航空航天学会秋季技术会议上发表。
- SE+PS-MoA3:A. Amassian 等人,2008 年 10 月 21 日在华盛顿州西雅图举行的 2008 年 AVS 秋季技术会议上发表。
- P Eh Hovsepian 等人,《真空镀膜机协会第 50 届技术会议论文集》(2007 年),第 602 页。
- V Sittinger 等人,第 49 届真空镀膜机协会技术会议记录(2006 年)343。
 纳狮 PVD/DLC 真空镀膜设备-IE
纳狮 PVD/DLC 真空镀膜设备-IE
