磁控溅射-双磁控和中频磁控溅射
高沉积速度和靶材利用率对对工业过程非常重要。尽管磁控管阴极的沉积速度相对较高,但不如蒸发过程的沉速度高(先前的博客中已解決。双磁控管/脉冲磁控管配置既可实现高沉积速率,又可提高材料利用率[1,2,3]。双磁控溅射使用中频(〜40kHz - 300kHz)脉冲电源和两个磁控阴极。双磁控管配置如图2所示,典型的电源脉冲如图3所示。该电源在周期的前半部分向一个磁控管阴极提供正脉冲,同时对另一个阴极进行负偏压,然后向另一个磁控管阴极提供正脉冲,同时对另一个阴极负向偏压。这种方式,一个阴极充当阳极,而另一个阴极充当溅射阴极。溅射仅在负偏压期间发生。这种过程非常适合于反应溅射[4,5,6]。
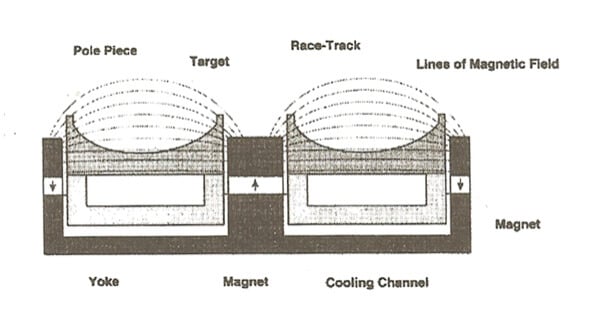

자기 제어를 위한 두 가지 포인트
- 阳极由于绝缘层的沉积而丢失(또는隐藏)
- 反應溅射过程中的充电和电弧形成
그림 4는 전력과 극성의 반전으로 인해 실제로 반응력 기간의 충전을 제거했습니다. 그림 4는 이중자 제어 방사 기간 등의 변환[2]을 보여줍니다.

最初开发了双磁控管技术来沉积绝缘材料 例如氧化物,氮化物和透明導電氧化物[4]具有相同靶材的平面磁控管通常彼此相邻放置,但在共溅射配置中,与不同靶材可以相距更远[5]。通过由负偏压的靶材(阴极)发射的二次电子被吸引到带正电的靶材(阳极)并基本上中和已沉积绝缘体的带正电的表面,可以减少电弧。表1比较了通过常规直流磁控溅射和中频溅射[1,2]沉积的四种材料的沉积速度和光学性能。所有情况下,我们都可以看到沉积速度最多可以增加5倍。

중주파 이중자 제어 방사선의 다른 박막 재료는 SiO2, Al2O3, MgO, CrN, ITO입니다.
下 反應溅射, 그것은 쌍자 제어 공학의 장점 중 하나입니다. 반응 사 후의 기본 원리는 연구 중[7,8], 그러나 쌍자 제어 공학의 용이성 제어[6]입니다,9] 另外,閉环控制器可用于使过程自动化[6] 目标氧化或中毒是降低沉积速度,引起电弧并降低密度的主要问题。反应溅射的技巧是保持靶表面清洁并防止"极消失",这直接与控制反应气体的分压有关。传统的磁控管,这是通过绘制反应气体分压和反应气体流量的磁滞回线来实现,如图5所示[10] 光学性能就决于沉积速度和反应性气体分压,如图6 [10] 并图7,11]所示。最初,与金属靶材的表面反应会消耗大量的反应气体。反应饱后,目標表面将被氧化并不会消耗额外的反应性气体,因此,o2유량이 적을 때 압력이 증가합니다. 이러한 상황이 발생하면 속도가 크게 저하됩니다. 하나의 목표가 완전한 중독입니다. 2的분압은 유동성을 증가시키며, 이러한 상황에서는 속도 영역 내에서 유동성 제어 및 제어 프로세스가 적용됩니다.


双磁控溅射的磁滞曲线看起来几乎相同,但是大多数中频系统使用某种形式的闭环或等离子体发射监测器控制,以将反应气体的分压和流量保持在最佳值[1,6,9]。几家公司销售闭环控制器。腔室配置的一个示例在图7 [6]中显示。系统使用目标电压的设定点和非常快的流量控制值来跟上目标表面发生的化学反应的步伐。简而言之,控制器将沉积过程中的目标电压与设定值进行比较,并相应地调整反应性气体流量。

使用双磁管和中频源进行共溅射的优点是可以精确控制各组件的数量[5]。显然,此过程程度需要两个磁管,但是使用中频源可能提供的地调节各目标的功率,并独立调节各目标的功率。这导致对组成的更多控制。图8 [5]는使用中频源的共溅射装置를 보여줍니다,这配置用于使用Ti和Al靶及O 2反应性气体来自定义TiAlO x的折射率。图9는 如何通过调节o 2分压来控制折射率。


쌍자 제어 방사선은 광학 다층층[9], CO2 [4,12]와 마모층[13]에도 사용할 수 있습니다. 그림 10에 표시된 것과 같이 쌍자 제어 방사선을 사용하는 경우 SiO 2 / Al 2 O 3反射涂層, 그 후 각 재료 위의 다음 이동 기반에서 전기 전도율과 광학적 투과율을 측정하여 길이와 같은 체적 밀도 및 일반 규정 수치에 따라 결정됩니다. 2分压和达靶材的功率[12]。使用两个In 0.9 Sn 0.1아티스트의 작업 속도, 작업 길이 등 2流量之間的關係目標如图11所示[12]。这里에서 우리는 일반적으로 볼 수 없는 5mΩ.cm에 가까운 값을 얻을 수 있으며, 또한 길이에 대한 의존성이 매우 큽니다.


이 두 가지를 사용하기 때문에 나트륨 층 압착판과 나트륨 복합 재료도 이중 자성체 제어 장치를 사용할 수 있습니다[3,13]. 그림 12는 RF 전원 장치를 사용한 Al 2 O 3 -ZrO 2纳米复合材料的高分辨率明场TEM [3]。引入ZrO2纳米团簇以提高Al 2 O 3的耐腐蚀性。TiN / TaN x(本月专栏 참조)多层具有摩擦学应用。使用Ti和 Ta靶在Ar + N2混合物中沉积多层膜[13] 电源的周期性自然会形成每种成分的纳米層。控制这些薄膜中的应力以减少剥落和附着力损失非常重要。多层结构中的应力可以通过層压板的厚度和氮气分压(也影响沉积速度)来控制。图13显示了应力对层厚度和总压力(Ar + N 2압력을 일정하게 유지합니다. 이 수치를 조정하면 압력 변화에서 압력 변화까지 적용력을 사용할 수 있습니다.


쌍자 제어 및 중주파 방사 예시표는 블로그(使用RF以及中频电源来沉积薄膜)에서 확인할 수 있습니다. 극과 방출 시 극자성의 상호 작용도 하나의 문제가 될 수 있습니다[1]. 모든 조건이 동일하지 않으므로 반드시 필요한 재료의 상태, 구성 및 성질에 따라 극 배치를 조정해야 합니다.
转至http://vtcmagblog.com/
참고: 참고
- U Heister 외, 제41회 진공 코팅기 학회 연례 기술 컨퍼런스 프로시딩 (1998) 187.
- T Winkler, 제45회 진공 코팅기 학회 연례 기술 컨퍼런스 논문집(2002) 315쪽.
- D H Trinh 외, J. Vac. Sci. Technol. A 24(2) (2006) 309.
- W -M Gnehr 외, 제48회 진공 코팅기 학회 연례 기술 컨퍼런스 논문집 (2005) 312.
- D J Christie 외, 제46회 진공 코팅기 학회 연례 기술 컨퍼런스 프로시딩 (2003) 393.
- L Lou 외, Advanced Energy Industries, Inc. 백서.
- R DeGryse 외, VT&C 2월 2008, 48.
- W D Sproul, 제36회 진공 코팅기 학회 연례 기술 컨퍼런스 논문집 (1993) 504.
- J Strumpfel 외, 제40회 진공 코팅기 학회 연례 기술 컨퍼런스 논문집 (1997) 179.
- W D Sproul 외, J. Vac. Sci. Technol. A 13(3) (1995) 1198.
- W D 스프로울과 B E 실비아, VT&C, 2(8) (2001) 32.
- A I 로고진 외, J. Vac. Sci. Technol. A 22(2) (2004) 349
- M Nordin et al. Sci. Technol. A 18(6) (2000) 2884.
 낙소 PVD/DLC 진공 코팅 장비-IE
낙소 PVD/DLC 진공 코팅 장비-IE
